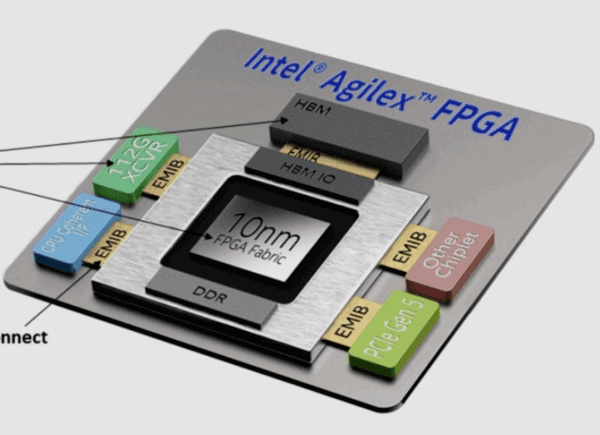
IC芯片封装技术的工艺流程
芯片封装工艺分为两段,分别叫前道(Front-of-line,FOL)和后道(End-of-line,EOL),前道(FOL)主要是将芯片和引线框架(Leadframe)或基板(Substrate)连接起来,即完成封装体内部组装。后道(EOL)主要是完成封装并且形成指定的外形尺寸。
(一)、前道生产工艺

下面,用示意图来简单介绍主要的加工工艺:
1.晶圆(wafer):
图2-1展示了一个从晶圆厂(Wafer Fab)出来的晶圆,上面布满了矩形的芯片,有切割槽的痕迹。

2.磨片(Backgrinding):
晶圆出厂时,其厚度通常都在0.7mm左右,比封装时的需要的厚度大很多,所以需要磨片。
图2-2是磨片工艺示意图,晶圆被固定在高速旋转的真空吸盘工作台上,高速旋转的砂轮从背面将晶圆磨薄,将晶圆磨到指定的厚度。通常,TSOP单芯片封装的晶圆厚度为0.28mm左右。

3.装片(Wafer Mount):
图2-3 装片工艺,上图展示了如何将晶圆粘贴到粘性蓝膜上。首先将晶圆正面朝下固定在工作台的真空吸盘上,然后铺上不锈刚晶圆固定铁环(Wafer Ring),再在铁环上盖上粘性蓝膜(Blue Tape),最后施加压力,把蓝膜、晶圆和铁环粘合在一起。
图2-3 下图展示了将晶圆固定在铁环上以后的情况:中央的晶圆被固定在蓝膜上,蓝膜被固定在不锈钢铁环上,以便后续工序加工。
4.划片(Die Sawing):

图2-4 划片工艺,上图表示高速旋转的金刚石刀片在切割槽中来回移动,将芯片分离。
图2-4 下图是完成切割的晶圆,芯片被沿着切割槽切开。
5.贴片(Die Attach):
图2-5a,芯片粘贴工艺,第一步:
顶针从蓝膜下面将芯片往上顶、同时真空吸嘴将芯片往上吸,将芯片与膜蓝脱离。

图2-5b,芯片粘贴工艺,第二步:
液态环氧树脂涂到引线框架的台载片台上。
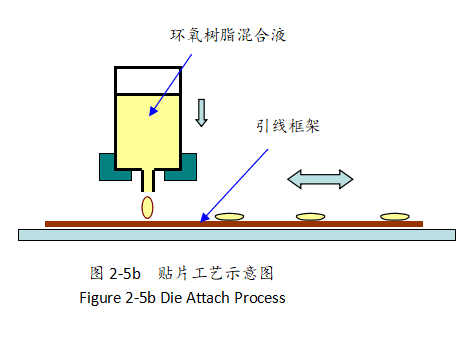
图2-5c,芯片粘贴工艺,第三步:
将芯片粘贴到涂好环氧树脂的引线框架上。

6.引线键合(Wire Bonding):
图2-6是用金线将引线框架的引脚和芯片的焊盘连接起来以后的示意,上图是截面图,下图俯视图。

(二)、后道生产工艺

1.塑封(Molding):
塑封是用环氧树脂将芯片及用于承载芯片的引线框架一起封装起来,保护芯片,并形成一定等级的的可靠性。

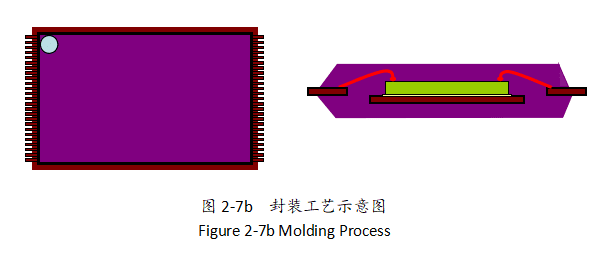
图2-7a 展示了塑封工序的工作原理。模具分成上下模,模具上有根据封装体尺寸所预先定好的模腔,其工作温度在通常在165-185℃范围内。将需要封装的引线框架放置到模具上,然后放入固体环氧树脂饼料,再合上模具并施加合模压力(至少在30吨以上)。
合模后,给注塑杆上施加压力,环氧树脂在高度高压下开始液化,于是在注塑杆的作用下,环氧树脂被挤入模腔中。由于环氧树脂的特性是先液化再固化,于是在被挤入腔中后,它将再次固化,形成我们所需要的外形尺寸。
图2-7b是注塑完成以后的示意,左图是俯视图,右图剖面图。
2.切筋(Trim):
图2-8是切筋以后的情况,对比图-9b我们可以发现,引脚之间的连筋已经没有了。切筋的作用是将引脚之间的连筋切开,以方便成形工艺。
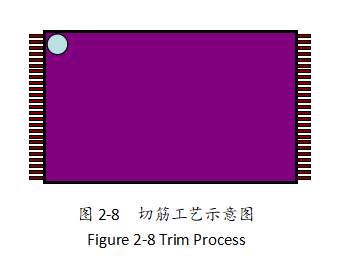
3.电镀(Plating):
图2-9是电镀以后的情况,对比图-10我们可以发现,引脚之间的颜色有了变化。电镀的作用是增强导电性能。

4.成形(Form):
图2-10成形工艺示意图,引脚的外形是由冲压模具来完成,器件被固定在模具上,刀具从上往冲压成形,然后将器件与引线框架分离,得到图1中的外形。成形工艺是半导体封装的最后一步,其外形尺寸有严格的行业标准,TSOP封装的具体尺寸请参见JEDEC MO-142, THIN SMALL OUTLINE PACKAGE FAMILY TYPE I,现行标准公布于2000年7月[5]。TSOP封装的总高度不得超过1.27mm、引脚节距0.5mm,塑封体厚度为1.0mm,目前最流行的TSOP48的长X宽=12X20。
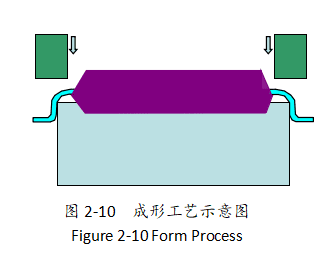
封测概况及巨头格局
目前,国内半导体封测市场主要由3家企业把持,它们是:长电科技,华天科技,通富微电。 但是由于半导体封测行业属于劳动密集型产业,本身利润率水平就不高,因此在技术差别不大的情况下,生产规模及成本管控决定了行业内公司的竞争力(2016年长电科技和通富微电完成并购并且后续整合完成之前,三家公司的封测技术差别不大)。 截止到2016年底,为了在未来的市场竞争中能够胜出,三家企业各自完成了阶段性的战略布局。
近年来,三家企业不约而同地开启了扩张之路,但方式并不相同。 长电科技及通富微电均通过外延并购来进行扩张,前者联合国家大基金、国内芯片制造龙头中芯国际花费7.8亿美元收购全球第四大封装厂星科金朋,后者则斥资3.71亿美元收购了AMD苏州和马来西亚槟城两座封测工厂各85%的股份,双方成立合资公司。
2016年华天科技耗资近20亿元,分别在天水、西安以及昆山三地进行集成电路高密度封装扩大规模项目、智能移动终端集成电路封装产业化项目以及晶圆级集成电路先进封装技术研发及产业化项目。 2017年华天科技完成了FC、Bumping、MEMS、MCM(MCP)、WLP、SiP、TSV、Fan-Out等技术和产品的自主研发,与此同时,华天科技FC、Bumping、六面包封等先进封装技术将华天科技的封装产品结构优化,封装产能得到提升。 三家公司通过2016年巨大的资本支出,实现了产能扩张和并购落地,也均取得了一定的成效,具体情况如下:
长电科技通过收购星科金朋,获取了SiP、FoWLP等一系列先进封装技术,借此抢占未来五年先进封装技术的先机,能够为国际顶级客户和高端客户提供下世代领先的封装服务。公司销售收入也在星科金朋并表后,一跃晋升2016年全球前10大委外封测厂第三位,业务覆盖国际、国内全部高端客户,包括高通、博通、SanDisk、Marvell、海思、展讯、锐迪科等。
华天科技通过过去一年同时在昆山、西安、天水三地的全面布局,指纹识别、RF-PA、MEMS、FC、SiP等先进封装产量不断提高,产品结构不断优化,已具备为客户提供领先一站式封装的能力,2017年公司的先进封装产能有望逐步得到释放。 其中,昆山厂主攻高端技术,深化国际战略布局。昆山厂目前主营晶圆级高端封装,订单量最大的是CIS封装,Bumping封装也开始逐步小批量的生产;西安厂立足中端封装,突破手机客户,以基本封装产品为主,定位于指纹识别、RF、PA和MEMS,MEMS产量已经突破1000万只/月,而指纹识别的产能也开始释放;天水厂定位以中低端引线框架封装与LED封装为主,是公司此前营收的主要来源,未来随着天水厂的扩产计划逐步完成并经历产能爬坡后,生产经营将逐步步入稳定状态,营收能力也有望实现较大幅度的提升。 而从技术上来看,华天科技的最大亮点要数指纹识别产品的封装技术,公司针对不同的需求而开发出了适合的指纹识别封装工艺,尤其是为瑞典FPC和汇顶开发的“TSV+SiP”指纹识别封装产品已经成功应用于华为系列手机。 除此之外,华天科技包括重力传感器、胎压检测传感器、隧道磁电阻效应传感器等在内的多种MEMS产品封装已经能够规模化量产;西安和天水基地FC封装产量快速提高,已经具备了“Bumping+FC+BGA/CSP”一站式服务客户的能力。
通富微电收购的AMD苏州、槟城两厂主要从事高端集成电路封测业务,主要产品包括CPU(中央处理器)、GPU(图形处理器)、APU(加速处理器)以及Gaming Console Chip(游戏主机处理器)等,封装形式包括FCBGA、FCPGA、FCLGA以及MCM等,先进封装产品占比100%。通过该收购,通富微电实现了两厂先进的倒装芯片封测技术和公司原有技术互补的目的,公司先进封装销售收入占比也因此超过了七成。
中国IC封测大陆工厂分布

© 版权声明
文章版权归作者所有,未经允许请勿转载。
相关文章
没有相关内容!

暂无评论...